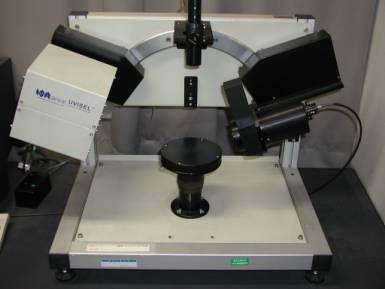
著者: 高木 章宏、修士課程1年生 (2003年度)
分光エリプソメトリー(分光偏光解析: Spectroscopic ellipsometry)法は、薄膜の光学定数(屈折率や消衰係数)や膜厚を測定する装置であり、その特徴としては
① 試料膜厚に対して数Åの測定精度をもつ
②
プローブとして光を用いる測定手法のため、高真空を必要とせず非破壊測定が可能
③ 表面数Åの構造に非常に敏感なため、表面の吸着層や酸化膜などの表面膜の存在まで感度よく検出することができる
ことが挙げられます。この分光エリプソメトリーから得ることができる光学定数(屈折率・消衰係数)は、薄膜の光学的特性を与える重要な物質定数であり、細野・神谷研究室では透明酸化物半導体薄膜に分光エリプソメトリーを用いることで、その光学定数を明らかにし、物性解析に用いています。
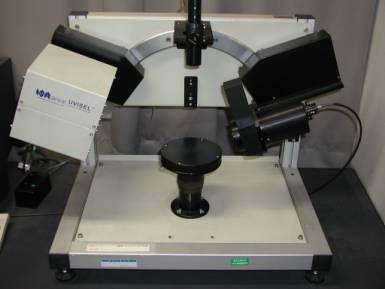
図1 分光エリプソメータ
光が試料表面で反射されるとき、光のp成分(電気ベクトルが入射面に対して平行な成分)とs成分(電気ベクトルが入射面に対して垂直な成分)とではそれぞれ異なった振幅変化と位相変化を生じます。したがって、一般的な試料では、直線偏光として入射された光が反射すると、楕円偏光になります。分光エリプソメトリーはこの性質を用いた装置で、白色光を試料に斜めに入射させ、試料表面や多層膜の内部で反射・干渉した反射偏光から、p成分とs成分の位相差Δと振幅反射率比tanΨを測定します。私たちが使っている装置では、これらパラメータを測定するのに、高速測定が可能な電気光学素子を用いています。
例えば、一枚の薄膜と基板だけからなる系を考えたとき、これら位相差Δと振幅反射率比tanΨからなる複素振幅反射率比ρ=tanΨ・exp(Δi)は、入射角φ、波長λ、基板の複素屈折率Ns( = ns-i ks)と薄膜の複素屈折率Nf ( = nf-i kf)とその膜厚dの関数であるので、入射角φ、波長λと下層の複素屈折率Ns ( = ns-i ks)が分かっており、かつ、波長を変化させて測定することにより、薄膜の複素屈折率Nf ( = nf-i kf)やその膜厚dなどを求めることができます。
さらに分光エリプソメトリーは、基板上に多層膜が形成されているような"薄膜系" の光学定数を知る上でも有効な手段であり、この場合は測定から得られる「基板の誘電関数と薄膜の誘電関数と膜厚からなる"擬誘電関数"」に対して積層モデルを対応させ、界面による多重反射・干渉を考慮した薄膜系の擬誘電関数を計算することで薄膜の光学定数を得ることができます。
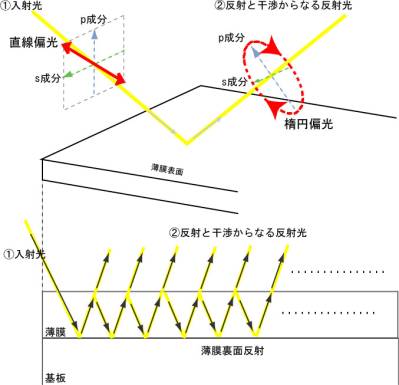
図2 分光エリプソメトリーの原理